Epitaxy от газовата фаза
Епитаксиален силиций филми отглеждат върху силиций и диелектрик (сапфир) субстрати за използване в химични реакции най-често се използват в микроелектрониката технология и се отлагат от пара-газова смес, в резултат на един от следните процеси.
1. Реакцията на редукция на съединенията с водороден халид (метод хлорид)
SiCl4 + 2Н2 ↔Si + Н Cl ↑
2. Реакциите disproportsionirovapiya силициеви халогениди
2SiCl2 ↔SiCl4 + Si
3. реакции пиролиза на силан (или силан хидрид метод)
SiH4 ↔Si + 2Н2 ↑
4. Реакционната Gazotransportnge
Si + 2HCl↔SiCl2 + H2 ↑
SiCl2 + Н2 ↔Si + 2HCl
Имайте предвид, че по-горе реакции имат кумулативен характер и не описват цялото многообразие от процеси постъпващия през епитаксиален процес. В този случай, често не е сигурно, що се отнася до отговора на въпроса, къде, в действителност, може да се провежда на гореспоменатите химични реакции. В един подход, се говори за хода на процеса върху субстрат, който играе ролята на катализатор, ускоряване на растежа на епитаксиален слой поради неговите физични параметри. В друг метод за това, само протичащ в газова фаза, когато субстрата вече образувани силициеви атоми се подават под формата на атомна лъч, бомбардиране субстратната повърхност. В този раздел не разглежда методи епитаксия от директен трансфер от източника на силиций субстрат във вакуум, епитаксия молекулно лъч, сублимация, и така нататък. Е., които са посветени на съответните точки.
Методът на хлорид за производство на силициеви епитаксиален филми е най-развитите в местната промишленост. Както изходните реагенти първата реакция се използва силициев тетрахлорид (SiCl4) трихлоросилан (SiHCl3) дихлорсиланът (SiH2 Cl2) и т. P., но най-често силициев тетрахлорид SiCl4.
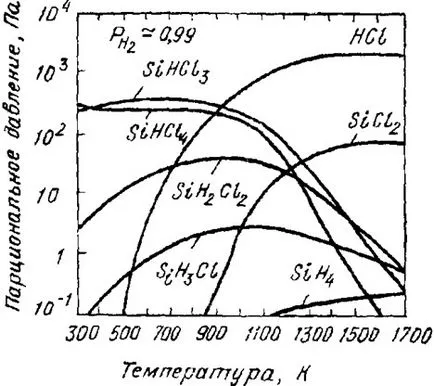
Фиг. 1. температурната зависимост на парциалното налягане на равновесие на съединенията, получени в газова фаза при налягане от 1 атмосфера, и съотношението на CL / Н = 0.01
Съгласно условията на химическо равновесие, излишък на водород с първата реакция е форма на силиций, и при подаване на системата солна киселина газ ецване солна киселина може да се извърши на силиций субстрат. Ние се обясни това по-подробно. Както вече бе споменато, първата реакция е да обобщим. В действителност, в системата се случи, най-малкото на следните реакции:
SiCl4 + Н2 ↔SiHCl3 + HCI,
SiHCl3 + Н2 ↔SiH2Cl2 + HCI,
SiH2 Cl2 ↔ + SiCl2 + Н2
SiHCl3 ↔SiCl2 + HCI,
SiCl2 + Н2 ↔Si + 2HCl,
Фиг. 1 показва зависимостта на смес състав и температура за често използвана технология по отношение на концентрацията на хлорен на концентрацията на водород е равно на 0,01. Веднага редица заключения от по-горе.
1. Всички химични реакции са обратими, т.е. При определени условия, скоростта на нанасяне на силиций може да бъде отрицателен (фиг. 2). Този факт е широко използван в случаите, когато е необходимо, например, да ецване повърхността на субстрата непосредствено преди нанасяне. Равновесие по този начин лесно може да бъде изместена в ляво чрез увеличаване на концентрацията.
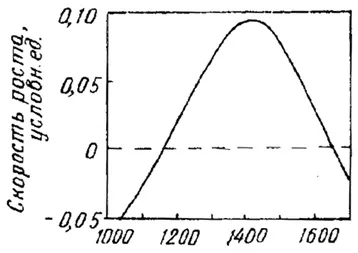
Фиг. 2. Зависимостта от скоростта на растеж на температурата на силиций на субстрат чрез химическо отлагане на пари
2. Както се вижда от фиг. 1, всяка температура съответства на състава на газовата смес, както и скоростта на растеж е пряко определя от тази стойност, най-малката промяна на температурата автоматично предизвиква промяна в скоростта на растеж и появата на дефекти.
3. Метод на филмово покритие може да се контролира, тъй като скоростта на химическата реакция, и скоростта на процесите на трансфер на маса, т.е.. Е. реагентите входящ и изходящ условията на реакционните продукти. Това е по този въпрос и основани механизми за управлението на процеса на растеж.
4. Както се вижда от списъка на реакции присъства и система нестабилно съединение SiCl2 силициев дихлорид на. способен не само водород, но и да се възстанови непропорционално за втората реакция.
Процесът на хлорид обикновено се провежда при температура в границите 1050-1300 ° С (типична операция), скоростта на растеж от порядъка на 1 микрон / мин, концентрацията на силициев тетрахлорид SiCl4 се поддържа на 0,5-1%, скорост на 0,1-1 т * е газ - 1 (в зависимост от конкретните условия на отлагане). С увеличаване на концентрацията на силициев тетрахлорид SiCl4 да реагира, и за сметка на условията на реакцията може да бъде създаден офорт силициеви субстрати. Когато концентрацията на SiCl4 понижаване на температурата на субстрата причинява растежа на поликристални и аморфни филми дори, докато повишаване на температурата на субстрата води до гъста единични кристални слоеве. Тези модели могат да бъдат обобщени в таблицата.
Един от основните недостатъци на метода на хлорид епитаксия крие във факта, че при високи температури субстрат (1200-1250 ° С) настъпва значително разпространение на примеси от субстрата в нарастващата epitaksialshy слой, т. Е. протича процес самостоятелно допинг. Самостоятелно допинг промени в профила концентрация в слой система субстрат епитаксиално. Филмите, получени по този метод, този ефект се повишава от присъствието в газова фаза, съединенията, съдържащи хлор, които могат да причинят подрязани и последващо прехвърляне на примеси от обратната страна на субстрата. За да се намали частично ефекта на самостоятелно допинг обикновено се използва за създаване на профил на концентрации в структурите на примес полупроводникови с малка стойност на коефициента на дифузия, например антимон или арсен флуорид вместо.
Хидрид метод на отглеждане епитаксиални слоеве на базата на трета реакция силан пиролиза при температура 1050-1100 ° С намаляване на температурата и липсата на хлориди значително намалява въздействието на самостоятелно допинг. Недостатъци на метода включва силен реагенти токсичност и възможността от експлозия на реакцията на спонтанно разлагане на силан в газовата фаза. Когато потокът от последната да агрегати субстрат падане, състоящи се предимно от аморфни силициеви частици, които значително увеличава дефицит на нарастващото филма. Спонтанни нараства с увеличаване на температурата на пиролиза, силан концентрация в сместа в присъствието на следи от вода H2O или О2 кислород. Типични режим отлагане метод хидрид определени температури на процеса в диапазона 1050-1100 ° С, съставът на сместа (4% SiHl4 + 96% аргон, хелий или водород), скорост на отлагане от 0.2-2 м / мин.
Използва за производство на епитаксиални слоеве от реакции силициеви диспропорциониране или реакции при транспортирането на газ в момента не се получи практическо приложение в промишлен мащаб, въпреки че техните знания, необходими за разбирането на процесите на епитаксиално, използвани в методите и за евентуалното производство на филми на други важни материали за микроелектроника.
Реакционната диспропорциониране може също да бъде осъществена в открит процес, но е предназначена за вътрешни или ампула процеси. Да предположим, че е необходимо да се получи силициев епитаксиално филм с помощта на следната реакция диспропорциониране:
Si + SiI4 ↔ 2SiI2
Към този флакон се зарежда в кварцова Si силиций и йод I2. флакон се вакуумира и се поставя в пещ dvuhzonovuyu така че една част от него с силициеви праймери е при температура Т1. а другият в Т2 и съдържа силиций, който служи като източник и Т1> Т2. Отличителна черта на реакцията на диспропорциониране е промяна на посоката, в зависимост от температурата на реакцията. Когато Т2 тя преминава от ляво на дясно, с предварително образуван SiI4 взаимодейства с изходния материал, образуващ нестабилна газообразно съединение SiI2. Поради топлинни потоци дифузионни SiI2 дифундира към субстрата, където реакцията отива от дясно на ляво при температура Т1. Новообразуваната SiI4 отново дифузна регион източник и т. D.
Забележете, че в този случай, отлагането се извършва при относително ниски температури (около 1000 ° С) температури, количеството на външни вещества въвежда в системата. минимум, което намалява вероятността от замърсяване на филма. В допълнение, по пред-почиства много лесно. Въпреки това, трудността на механизация, нисък метод ампула производителност, има сериозни грешки.
Процесът на отглеждане епитаксиални филми от газовата фаза обикновено включва следните основни етапи.
Етапите на отглеждане епитаксиални филми от газовата фаза
1. Получаване на субстрата вафли с избрана ориентация и предварително определена степен на повърхността усъвършенстване.
2. Почистване на система за култивиране на чужди вещества.
3. Зареждане на плаки в реактора.
4. прочистване реактора с инертен газ и водород.
5. Нагряването на плаките в реактора и условията за създаване на офорт газ, за да се почисти плаките и отстраняване на нарушена механично полиране на повърхностния слой.
6. Създаване на условия за режим филм отлагане.
7. статуси реагенти за утаяване и (ако е необходимо) дотирането на епитаксиално филм.
8. Прекратяване на фуражни реагенти и продухване на системата с водород.
9. намалява с предварително определена температура програма в реактора, докато напълно се изключва нагряването.
10. Обдухва система с инертни газове.
11. разтоварни реактора.
В момента, интензивната работа по създаването на напълно автоматизирани системи, обслужващи този цикъл оптимално.
Оптимизация на епитаксиално израстване е невъзможно без подробно разглеждане на движението в смес на реактора. Например да приемем, условията на потока на потока в най-простата хоризонталната реактора е илюстрирано на фиг. 3.

Фиг. 3. Схема простият хоризонталната реактора
Както се вижда от тази фигура в реактора при различните точки съществува рязко различаващи се условия. Близо до граничните стени се образуват зони, в които скоростта на потока, температура, концентрация на реагентите може да се различават значително от стойностите, характерни за входящия поток на сместа. Проучване на кинетиката на образуване на филмите, ние трябва да разгледа транспортните процеси на реактивите през границата на субстрат смес и отстраняване на реакционните продукти от него.
За да се постигне хомогенност на депозираните филмите е необходимо да се осигури равни условия за всички субстрати, които в момента е практически невъзможно да се разбере реактора.
В епитаксиално технология, разработена няколко типа хоризонтални и вертикални реактори, показани схематично на фиг. 4 (реактор хоризонтален тип, - вертикална типове реактори).
Вертикалните реактори осигуряват най-добрите условия за равномерно нагряване на субстратите и еднородността в състав смес входящия газ. Може да се нагрява чрез нагряване на притежателя на графит субстрат, външния източник на светлина или вътрешно съпротивление нагревател външен висока честота на индуктор, стените на реактора може да се охлажда със сила, се намалява вероятността от замърсяване на субстратите.
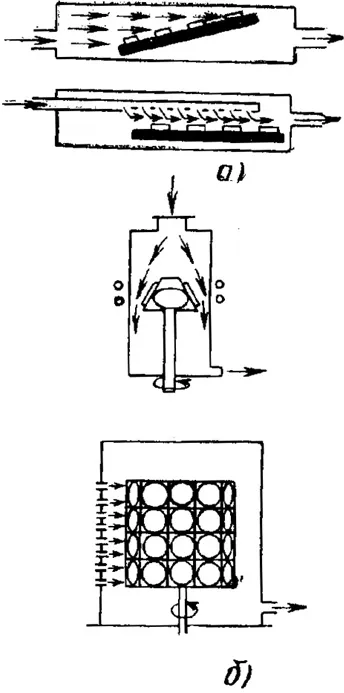
Фиг. 4. вида на реактора: а - хоризонтална; б - вертикална
Вертикалните реактори работят периодично, че е техния значителен недостатък, обаче, наличието в инсталацията на няколко реактора включен опростява проблемът (до, например, в един от тях има натрупване на филми, другата ненатоварено и т. Г.).
Допинг епитаксиално силициеви структури, произведени с помощта на групи елементи III и V се въвежда в процеса на епитаксия под формата на летливи съединения. Най-подходящи са тези, хлориди и хидриди на съответните елементи, по-специално хлориди: RSl3. AsCl3. SbSl3. SbCl5. BCl3. BBr3. и фосфин PH3. арсин AsN3. диборан B2 H6. stibine SbH3. и повече за предпочитане използването на хидриди.
Има следните основни методи на допинг епитаксиални слоеве на смеси газ-пара, течно и газоразрядни лигатури.
Когато допинг примеси на газовата смес пара се разрежда смес източник на инертен газ, с летлив хидрид се добавя към главния поток навлиза в реактора.
Един обещаващ метод за контрол на концентрацията на примес в епитаксиален слой по време на растежа е electrospark метод легиране или газоразрядни. В този случай, между електродите в реактор, освобождаване искра се генерира, в който процеса на разпръскване на материала електрод. Както се използва материал електрод за производство на силициеви слоеве с п-тип проводимост антимон сплав Sb + 0,1% P или Sb + 1% As.
За да се получи епитаксиални слоеве с р-тип проводимост се използват електроди от LaB6 лантановото борид. AlB12 алуминиев борид. борен карбид концентрация В4 С се въвежда в промяната на газова фаза примеси, за адаптиране на честотата на изпълнението на искра. Устройство за епитаксия на силиций е показано на фиг. 5.
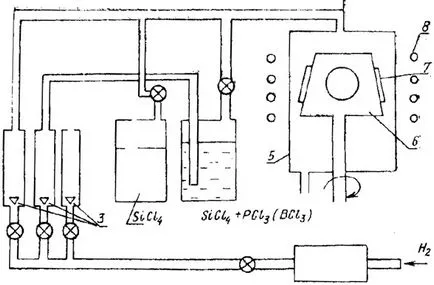
Фиг. 5. монтажни схеми за силиций епитаксия
Водородът се подава към система за пречистване, когато е напълно освободен от онечиствания чрез преминаване през катализатора (кислород следгоривната) и паладий (платина) филтър. Водородът поток се регулира чрез клапан, и скоростта на потока може да се контролира от поплавък ротаметър 3. В съответна двойка улавя barbatore водород силициев тетрахлорид SiCl4. съдържащ примес, и газовата смес пара влиза в реактора 5, където държач субстрат 6 разположен върху субстрата 7. притежателя на субстрата се загрява от генератора на индуктор RF 8 и може да се върти за изглаждане колебания и поле температура създават еднакви условия за растеж на всички субстрати.